精密自动化的标杆

MRSI-M3 3微米贴片机本
蘸胶粘结
更多设备详细信息,欢迎与我们的销售联系。
MRSI-M3
3微米贴片机
高度可自由配置的 MRSI-M3 平台,使资产得到最优的保值。该系统集合了3微米精度、自动化、速度和可靠性等特点,是其它设备无可比拟的;诸如共晶焊、紫外环氧贴片以及倒装芯片装配等原位装配过程都可以实现。MRSI-M3 3微米贴片机是微波模块、红外传感器、微电子机械系统 (MEMS)、多芯片模块、堆叠式组装、混合器件和光电子封装等制造商的理想产品。
从细小的芯片到宽大的传感器,MRSI-M3 3微米贴片机能够为最先进封装提供灵活而多样的封装能力,而且不会降低生产效率、质量和可靠性。
优点
MRSI-M3 采用先进的铸造聚合物基座,使高速而精确的运动成为可能,且几乎没有停滞时间。超大的工作空间,可根据客户需求进行各种配置(参见选配功能标签)
与重大优点相当的先进功能:
高速及高精度– 配备一套先进的由无刷直流线性伺服电机驱动的轴系统,附带直线光栅尺编码器反馈,保证高速度精确的运动。
高设备效率及高产品质量– 内置的内部温度监测确保了贴放的一致性。为电机等已知热源设计了气体冷却;确保热膨胀维持在最低限度。
最优的贴放良率– 系统的闭环压力控制功能可使贴放压力低至10克,对易碎的砷化镓 (GaAs) 芯片进行贴放。反之,可编程设置将贴放力提高到2千克。
供料选项多样– 可从华夫盘 (waffle pack)、Gel-Pak™、晶圆、带料、卷料和定制料盘上拾取芯片。
资产利用最大化MRSI-M3 机台的设计可处理多种工艺。环氧点胶泵、环氧蘸胶及带刮擦和温度控制的共晶焊等选配功能令MRSI-M3 3微米贴片机自成一整套组装解决方案(详细信息请查看特性标签了解)。
MRSI-M3 的超大工作区域,最多可容纳72个华夫盘;也可使用 Gel-Paks™、带式喂料器及晶圆。通过可简便拆装的托盘,华夫盘可从前端和后面装载。华夫盘喂料器可很容易地集成。而且华夫盘适配器可与自动晶圆更换器配合使用。环氧蘸胶、原位共晶焊及其它客制化选配功能可在其超大的工作区域内同时容纳。 MRSI-M3 贴片机的设计,意在满足高速运动的同时,实现超高精度3微米级的贴放。聚合物基座、低重量的构架和强大的线性电机等设计,可保证快速加速及亚微米级的分辨率。整个系统达到了前所未有的功能和技术水平,使其具有更高的性能价值同时兼具投资保值功效。最终结果就是其实现高生产率的同时具有无匹的精度。 通过闭环压力反馈功能,可实现对砷化镓 (GaAs) 和磷化铟 (InP)等 III-V 族半导体器件,以及具有易碎微结构的MEMS器件进行取放。作用在芯片上的贴放力最低可达10 克。每种类型元件的贴放压力和速度都可编程控制,因此,每种芯片的取放均以其独有的程序设定并控制好的压力进行。 MRSI-M3 先进的视觉系统,令芯片的快速探测和360°内的定向成为可能。采用边界追踪或图形识别定位芯片的中心或应用的关键特征。快速而精确的定位功能,使客户可直接使用与MMICs类似的芯片和激光二极管,而无需预定位。全局和局部视觉对位,应用于嵌套式基片及特征,这使得复杂组件的快速而无差错地加工成为可能。设备配备一台上视相机,用于处理倒装芯片和具有底部特征的零件。 每台相机的环形光和同轴光的光强度均可编程控制。可为芯片识别及对位提供最优的照明环境。多色背景光的应用可使设备获取低对比度元件的最佳图像。红、绿和蓝可编程照明,在处理诸如氧化铝表面上的金线这样具有挑战性的对位时是种强有力的工具。这种高级视觉工具包最优化了设备性能,令机台不会因视觉对位的错误中断生产。 MRSI-M3 直观的图形化用户界面在 Windows™ 系统上运行,简化了设置及生产工艺。软件包括一套华夫盘及芯片的预编程数据库。额外的组件简单易学,且提供给所有基片程序。校准程序、离线编程及CAD下载等功能意味着编程简单、快速。MRSI-M3 是 MRSI Systems 点胶设备的完美伴侣,因其共享了相同的软件用户界面。超大的工作区域
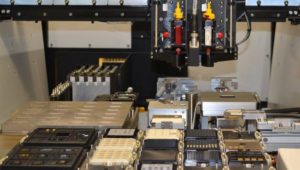
高速生产
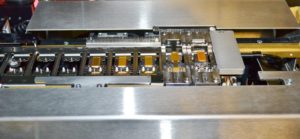
压力控制
先进的视觉系统,可进行360°芯片定向

可编程的多色光照明
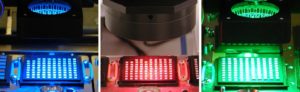
MRSI 系统 Windows 工作软件
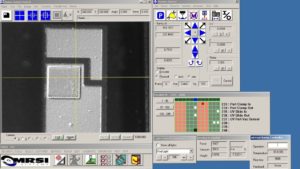
采用模块化输送工具,确保生产过程中实现快速而简便地更换 – MRSI-M3 支持三种产品输送模式,即连线传送式、料盒仓至料盒仓装卸式或单机模式。系统的传送带可输送料舟、夹具盘、引线框架及料板。 优点: 设备配有不限数量的拾取和蘸胶工具头 – MRSI-M3 配有一个有十三个工具位的工具更换仓,可快速自动更换工具头。还可额外附加若干工具头更换仓,以容纳更广范围的工具头。工具头更换仓内有圆形表面拾取工具头、环形和倒金字塔型吸嘴及蘸胶头。这特别适合于需要大量专用工具的工艺流程,如共晶焊应用。 优点: 直接从晶圆拾取可最大限度地减少芯片传输并简化供应链 – MRSI-M3 的自动晶圆喂料器,包含自动θ补偿、伺服控制的拾取工具头和顶针的同步化闭环运动、晶圆测绘和墨点探测及快速更换顶针束。超薄器件无需顶针系统。 通过拾取工具头和顶针的同步化运动实现对薄而易碎芯片的精微拾取。自动θ补偿将芯片沿着θ轴与顶针束对齐。支持晶圆测绘和墨点探测,确保只会处理好的芯片。顶针束和顶针帽的快速更换,使不同类型器件间的切换简单而精确。 优点: 高可靠性封装的灵活而高产的解决方案 – 可以为 MRSI-M3 配备共晶焊套件,成为金硅、金锡和金锗焊接工艺的理想选择。使用此套配置,可以实现在基板上、TO管壳上以及蝶型封装上进行共晶焊的应用。对于大批量共晶应用,可选配渐进式加热料舟式引料器 (Progressive Heated Boat Indexer)。 系统支持直接共晶焊和回流共晶焊两种工艺。该配置包括可快速升温(闭环脉冲加热)的回流台。经过加热的氢气及氮气保护气体覆盖于热板表面。回流台设计带有真空吸持和零件装夹的能力。系统可自动地将基片或封装转送至工作台以进行共晶焊,并将完成的零件由工作台转送出去。 共晶台可以编程控制,使之与您特定的共晶工艺要求相匹配。 优点: 全自动共晶贴片可降低劳动成本、提高良率 – 自动化的连线材料传输系统与MRSI极其可靠的原位共晶焊选件(提供链接到上文第4节)相结合,为共晶贴片工艺提供了一套高速、全自动的交钥匙式的解决方案。 连线式物料传输系统将基板载体(料舟)装载到传送带上。传送带将料舟转运到焊接区。 支持各种焊接工艺: 就金-硅直接共晶焊而言,系统首先将封装对位,然后拾取并贴放芯片,通过刮擦(可变幅度和频率)完成共晶焊。经加热的氢氮保护气体覆盖在焊接区上。 就锡膏回流共晶焊而言,如砷化镓 (GaAs) 和氮化镓 (GaN) 芯片的金-锡 (Au/Sn) 共晶贴片,系统先将封装对位,然后拾取焊料片并贴放于封装上(如有需要,焊料片可以预置)。然后,拾取并贴放芯片,同时,采用脉冲加热的共晶台将焊接工位升温,并通过刮擦(可变幅度和频率)完成共晶回流。也使用经加热的氢氮保护气体覆盖在焊接区上。 优点: 通过原位固化得到受控的成品精度 – 有源光缆 (AOCs) 装配等应用,不能接受贴放后环氧树脂固化操作过程中造成的贴放精度损失。比如透镜,在芯片焊接之后需要非常精确地放置,以确保系统性能达到最佳。在这类情况下,原位紫外光固化是一种解决方案,零件贴放完成后就地进行固化,消除环氧树脂固化过程中零部件移位的可能性。 该紫外固化选项包括专用的紫外固化环氧树脂点胶硬件以及固化配件。这包含易于清洗且通过时间/压力精确控制的点胶泵,用于罐装可用寿命短的材料。 自动遮蔽式紫外灯为点胶针提供保护,确保点胶针头不会由于紫外光意外照射,而导致点胶针头阻塞。 优点: 在同一设备上实现点胶和贴放 – MRSI-M3 开放式平台可以配备双针筒式螺杆点胶泵,从而对作为设备核心的装配功能进行有益补充。因此,单台设备就可以进行贴片、围堰和材料填充,或者盖板贴放材料的点胶;随后,作为整个工艺的一部分,完成芯片或盖板的贴放。因而在单个平台上可实现完整的装配工艺。 此外,MRSI-M3 的点胶泵还为小胶点或区域填充时的点胶提供精密的胶量控制。主要特性包括: 优点 在单一平台上可以使用多种环氧材料,完成各种尺寸芯片的贴放,实现复杂的组装– 配备具有多个环氧树脂槽的旋转蘸胶盘,用于蘸胶。 而点径的大小由沟槽的深度和蘸胶头的尺寸决定。 蘸胶(或涂抹)工具可与标准拾取工具互换,皆可通过在蘸胶盘中蘸取(环氧树脂)然后点于基片上形成非常小的胶点。单个胶点最小可达0.004″(100微米)。还可通过蘸胶头的成组联动获得更高的产量。 优点:物料输送
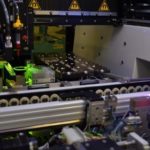
工具头更换
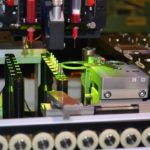
晶圆处理
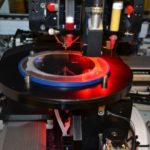
单机式共晶焊
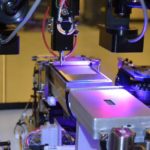
连线共晶功能
原位紫外光点胶和固化

点胶功能
环氧蘸胶
